НтЖСЃКICЗтзАаавЕЕФзюаТММЪѕКЭЪаГЁЧїЪЦ
ДЋЭГЖрЦЌаОЗтзАгыFOWLP
FOWLPгаМИжжБфЬх,УПжжЖМЪЙгУЩдгаВЛЭЌЕФжЦдьВНжшЁЃFOWLPзщМўПЩвдЪЙгУФЃбЙгХЯШ(mold-first)СїГЬДДНЈ,ЦЌаОУцГЏЯТЛђУцГЏЩЯАВзА,ЛђепЪЙгУRDLгХЯШ(RDL-first)зщМўЁЃ
ФЃбЙгХЯШЗНЗЈ
ЦЌаОЪЙгУСйЪБеГКЯВуЛђШШЪЭЗХВуСЌНгЕНдиЬхЩЯ,ШЛКѓНЋЦфФЃжЦЕНЗтзАжаЁЃШчЙћЦЌаОУцГЏЯТАВзА,НгЯТРДЕФВНжшЪЧЪЭЗХСйЪБВу,СЌНгRDL,аЮГЩЭъГЩЗтзАЕФКИЧђЁЃШчЙћЦЌаОУцГЏЩЯАВзА,дђашвЊвЛаЉИНМгВНжшЁЃ
ЪзЯШ,ЕЅИіЦЌаОI/OСЌНгБиаыЭЈЙ§дкЦфЩЯЬэМгЭжљРДРЉеЙ,ШЛКѓдйНјааЖўДЮГЩаЭЁЃГЩаЭКѓ,ЧЖЬѕЕФБГУцБиаыНгЕи,дкСЌНгRDLКЭаЮГЩКИЧђжЎЧАТЖГіжЇжљЁЃ
RDLгХЯШЗНЗЈ
RDLЪЙгУСйЪБЪЭЗХВуСЌНгдиЬх,ЖјЦЌаОСЌНгЕНRDLЁЃШЛКѓЪЧзщзАГЩаЭЁЂдиЬхЪЭЗХЁЂКИЮ§ЧђГЩаЭЁЃетСНжжЗНЗЈЕФзюКѓвЛВНЖМЪЧНЋзщМўЗжПЊ,ЪЙетаЉзщМўећЬхаЮГЩЕЅЖРЕФЦїМўЁЃ
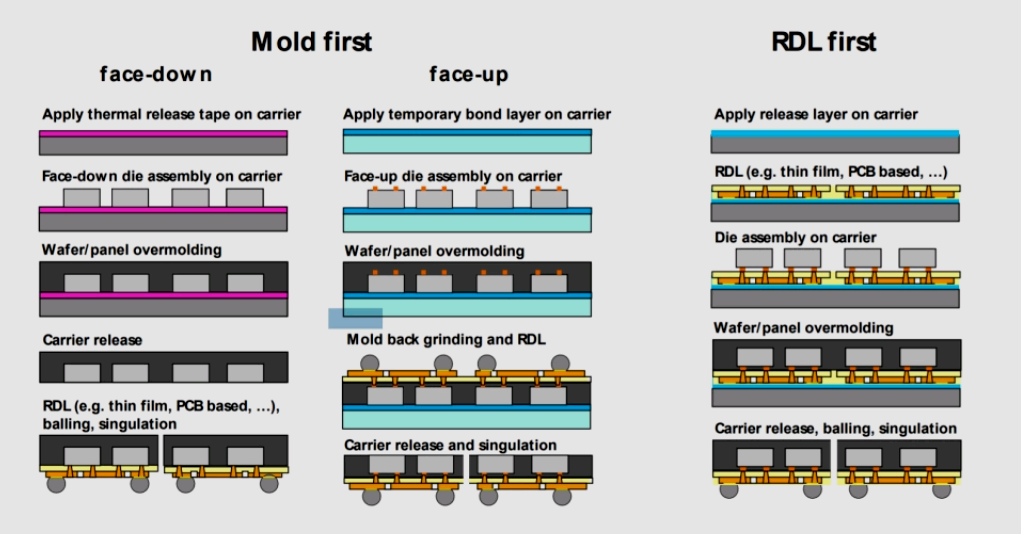
FOWLPММЪѕЕФСНжжЗНЗЈ
етаЉЗНЗЈОпгаВЛЭЌЕФГЩБОКЭадФмШЈКтЁЃдкГЩБОЗНУц,ФЃбЙгХЯШУцГЏЯТЗНЗЈБмУтСЫжЦзїЭжљКЭбаФЅ,вђДЫжЦдьГЩБОНЯЕЭ;зюЪЪКЯЕЭI/OЪ§ЕФгІгУ;ЕЋЪЧ,ДцдкзХЦЌаОвЦЮЛЁЂОЇдВЧЬЧњЕШЮЪЬт,ЯожЦСЫдкИДдгЖраОЦЌЗтзАжаЕФгІгУЁЃ
УцГЏЩЯЕФЗНЗЈМѕЩйСЫетаЉЮЪЬт,ВЂдкШШЙмРэЗНУцгагХЪЦ,вђЮЊаОЦЌБГУцЭъШЋБЉТЖ,гаРћгкЩЂШШЁЃ
дкадФмЗНУц,гыЦфЫћСНжжЗНЗЈЯрБШ,УцГЏЯТЕФЗНЗЈЕФСЌНгТЗОЖИќЖЬЁЃетСНжжЗНЗЈЖМгаЭжљ,ПЩвдНЋСЌНгбгЩьЕНRDL,ЭЌЪБдкаОЦЌЯТгавЛВуВФСЯ,діМгСЫСЌНгжЎМфЕФМФЩњЕчШн,ДгЖјгАЯьСЫЦфИпЦЕадФмЁЃ
2ЃЎ5DЕН3D ICЗтзАЕФЙиМќЪЧTSV
дк2ЃЎ5DЗтзАжа,ЦЌаОВЩгУЖбЕўЛђВЂХХЗХжУдкЛљгкЙшЭЈПз(TSV)ЕФжаМфВуЖЅВПЁЃЕзВПЕФжаМфВуЬсЙЉаОЦЌжЎМфЕФСЌНгЁЃ2ЃЎ5DЗтзАММЪѕЪЧДЋЭГ2D ICЗтзАММЪѕЕФвЛИіНјВН,ЫќЪЙМЃЯпКЭПеМфИќМгОЋЯИЁЃ
2ЃЎ5DЗтзАЭЈГЃгУгкИпЖЫASICЁЂFPGAЁЂGPUКЭФкДцЁЃ2008Фъ,XilinxНЋЦфДѓаЭFPGAЗжГЩСЫЫФИіИќаЁЁЂСМТЪИќИпЕФаОЦЌ,ВЂНЋетаЉаОЦЌСЌНгЕНвЛИіЙшжаМфВуЩЯ,ДгЖјЕЎЩњСЫ2ЃЎ5DЗтзА,зюжеГЩЮЊСїааЕФИпДјПэФкДц(HBM)ДІРэЦїМЏГЩЁЃ

TSVСЌНгЕФЙІФмЭъећЕФ3DЗтзА
дк3D ICЗтзАжа,ТпМЦЌаОЖбЕўдквЛЦ№,ЭЈЙ§ЭTSVдкЙшаОЦЌжЎМфЪЕЯжДЙжБЛЅСЌ,ВЂЪЙгУгадДжаМфВуСЌНгЦЌаОЁЃгыЭЈЙ§ЕМЕчЭЙЕуЛђTSVНЋдЊМўЖбЕўдкжаМфВуЩЯЕФ2ЃЎ5DВЛЭЌ,3D ICЗтзАВЩгУЖрВуЙшОЇдВВЂЭЈЙ§TSVНЋдЊМўЖбЕўдквЛЦ№ЁЃ
TSVЪЧ2ЃЎ5DКЭ3DЗтзАНтОіЗНАИжаЕФвЛЯюЙиМќММЪѕ,ЫќЬсЙЉСЫвЛжжДЉЙ§ЦЌаОЙшОЇдВЕФДЙжБЛЅСЌЁЃетжжЗтзАЪЧвдОЇдВаЮЪНжЦдьЕФ,РяУцЬюГфСЫЭЁЃTSVЪЧвЛжжДЉЙ§аОЦЌећИіКёЖШЛђЛљАхбгЩьЕФГЄЭЈПзЕчЦјСЌНг,ЫќДДНЈСЫДгаОЦЌвЛВрЕНСэвЛВрЕФзюЖЬТЗОЖЁЃШЛЖј,TSVГ§СЫздЩэЯджјЕФЕчЦјЬиадЭт,ЛЙЖдЦфИННќЕФЦїМўКЭЛЅСЌЕФЕчЦјааЮЊВњЩњМфНггАЯьЁЃ
ЮЊСЫОЋШЗЕиФЃФтвЛИі2ЃЎ5D/3DвьЙЙЯЕЭГ,ЩшМЦепашвЊДгетаЉ2ЃЎ5D/3DдЊЫиЕФЮяРэНсЙЙжаЬсШЁОЋШЗЕчВЮЪ§ЕФЙЄОп,ШЛКѓНЋетаЉВЮЪ§ЪфШыааЮЊЗТецЦїЁЃРћгУЭъећзщМўзАХфЕФ3DЪ§зжТЯЩњФЃаЭ,ЩшМЦепПЩвдзМШЗЕиЬсШЁГі2ЃЎ5DКЭ3DФЃаЭжаЕФМФЩњад,вдЗжЮіадФмКЭЪЪЕБЕФавщзёДгадЁЃ
жЕЕУзЂвтЕФЪЧ,2ЃЎ5DКЭ3DЖбЕўЖМЛсВњЩњИїжжХМШЛЕФЮяРэгІСІ,Р§ШчдкАВзАЙ§ГЬжаЛљАхЧЬЧњКЭХізВв§Ц№ЕФгІСІЁЃЩшМЦШЫдББиаыФмЙЛЗжЮіетжжаОЦЌЗтзАНЛЛЅзїгУв§Ц№ЕФгІСІМАЦфЖдЦїМўадФмЕФгАЯьЁЃвЛЕЉЗтзАНгНќЭъГЩ,ашвЊЕМГіОЋШЗЕФ3DЗтзАШШФЃаЭ,вдБудкЯъЯИЕФPCBКЭШЋЯЕЭГШШЗжЮіжаЪЙгУ,НјЖјЖдЯЕЭГЭтПЧНјаазюжеЕїећ,ВЂгХЛЏздШЛКЭ/ЛђЧПжЦРфШДЁЃ

3D ICЗтзАЕФШШЗТец
 ЗжЯэ
ЗжЯэ
зюаТЛюЖЏИќЖр
-
5дТ8-10ШеСЂМДБЈУћ>> ЙњМЪЮяСїНтОіЗНАИеЙРРЛс
-
5дТ10ШеСЂМДЯТди>> ЁОЪЧЕТПЦММЁПОЋбЁЁЖЦћГЕ SerDes ЗЂЩфЛњВтЪдЁЗАзЦЄЪщ
-
5дТ16ШеЛ№ШШБЈУћ>>> OFweekяЎЕч/АыЕМЬхаавЕЪ§зжЛЏзЊаЭдкЯпбаЬжЛс
-
5дТ28ШеСЂМДЙлПД>> ЁОдкЯпбаЬжЛсЁПAnsysОЕЭЗЕуНКПЩППадММЪѕМАЗНАИ
-
5дТ31ШеСЂМДБЈУћ>> ЁОЯпЯТТлЬГЁПаТЬЦПЦММ2024ЮДРДДДаТЗхЛс
-
8дТ27-29ШеТэЩЯБЈУћ>>> 2024ЃЈЕкЮхНьЃЉШЋЧђЪ§зжОМУВњвЕДѓЛсєпеЙРРЛс
- 1 ДДаТЧ§ЖЏЁЂПЊЗХЙВЯэЁЂЙЄОпИГФмЃЌжњСІЙЄвЕЦѓвЕЙЉгІСДЪ§жЧЛЏзЊаЭЩ§МЖ
- 2 ИГФмаТжЪЩњВњСІ | ИёСІЙЄвЕзАБИаТЦЗЗЂВМЛсдВТњейПЊ
- 3 iEiЭўЧПЕчвНСЦЦНАхЕчФдIASO-W10B-N6210
- 4 жЧФмжЦдьжЎТЗЛЙгаЖрдЖЃП
- 5 ЫежндДПиЃКДђдьгХжЪМЦЫуЛњВњЦЗЃЌжњСІЩњВњЩњЛюИпаЇБуНн
- 6 Ansys ЗлФЉ/ПХСЃСїЖрЮяРэЗТецММЪѕНщЩмМААИР§ЭјТчбаЬжЛс4дТ23Шее§ЪНЩЯЯпЃЁ
- 7 ВЉЪРСІЪПРж2023ФъЯњЪлЖюдйДДаТИп Л§МЋгІЖдЮДРДЬєеН
- 8 ЙЄвЕШэМўОоыЂPTCзюДѓЙІГМЭЫСЫ
- 9 ЙЄвЕЩЯТЅДђдьЯжЪЕАцЁАФІЬьЙЄГЇЁБ
- 10 ЁОВЮЛсжИФЯЁП2024аЧЛ№ЩњЬЌДѓЛсбћФњВЮЛсЃЁ
- ИпМЖШэМўЙЄГЬЪІ ЙуЖЋЪЁ/ЩюлкЪа
- здЖЏЛЏИпМЖЙЄГЬЪІ ЙуЖЋЪЁ/ЩюлкЪа
- ЙтЦїМўбаЗЂЙЄГЬЪІ ИЃНЈЪЁ/ИЃжнЪа
- ЯњЪлзмМрЃЈЙтЦїМўЃЉ ББОЉЪа/КЃЕэЧј
- МЄЙтЦїИпМЖЯњЪлОРэ ЩЯКЃЪа/КчПкЧј
- ЙтЦїМўЮяРэЙЄГЬЪІ ББОЉЪа/КЃЕэЧј
- МЄЙтбаЗЂЙЄГЬЪІ ББОЉЪа/В§ЦНЧј
- ММЪѕзЈМв ЙуЖЋЪЁ/НУХЪа
- ЗтзАЙЄГЬЪІ ББОЉЪа/КЃЕэЧј
- НсЙЙЙЄГЬЪІ ЙуЖЋЪЁ/ЩюлкЪа




















ЗЂБэЦРТл
ЧыЪфШыЦРТлФкШн...
ЧыЪфШыЦРТл/ЦРТлГЄЖШ6~500Иізж
днЮоЦРТл
днЮоЦРТл