当前位置:
OFweek 智能制造网
> 正文
解读:IC封装行业的最新技术和市场趋势
2021-01-04 08:44
探索科技TechSugar
关注
芯粒为3D IC封装锦上添花
还有一种使用芯粒(chiplet)的3D IC封装,是由AMD发明的,台积电、英特尔、华为海思都在研究。它可以实现CMOS器件与非CMOS器件的异构集成,或许有助于让摩尔定律继续下去。这个想法是将一个大的SoC分解成更小的芯粒,以提高良率和降低成本,同时提高客户的可重用性。芯粒模式允许设计人员像搭积木一样制造芯片,利用各种IP而不考虑它们是在哪个节点或用什么技术制造的;它们可以构建在各种材料上,包括硅、玻璃和层压板。
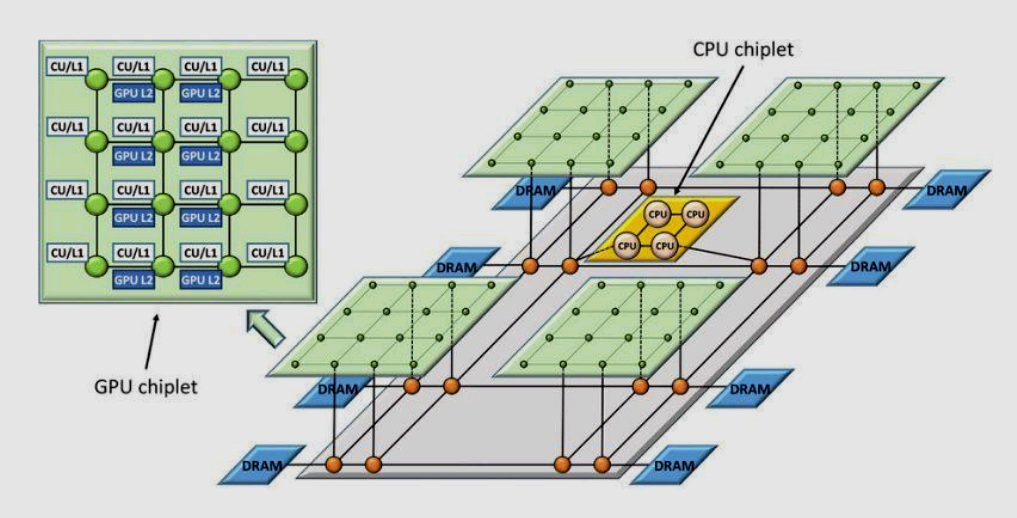
芯粒有望延续摩尔定律
下一代IC设计人才必须懂封装
美国乔治亚理工学院(Georgia Tech)教授、超大规模集成电路(VLSI)数字暨混合信号设计专家Arijit Raychowdhury表示,先进IC设计的新疆域在于封装。
他说:“封装是一个设计工程师必须了解的。”先进IC设计的重点已经从工艺技术转向封装技术,但问题在于“业界对于这种转移将如何进展的了解不够。”他认为台积电是一家在这方面表现得比较好的公司。
他指出:“芯片产业已经意识到,依循摩尔定律的工艺微缩速度已经趋缓,而产业界似乎不愿意面对芯片设计即将发生的巨变──从工艺到封装技术的转变。”
现在,晶体管微缩已经接近极限,但从技术上来看,也许微缩演进的速度不如我们想的那么快。以内存制造技术或后道工艺晶体管技术为例,他认为还会有很多新的东西出现,产业界应该在这个特定领域快速行动起来,去探讨这方面的“黑魔法”。
面对封装的技术演进和挑战,你准备好了吗?
声明:
本文由入驻维科号的作者撰写,观点仅代表作者本人,不代表OFweek立场。如有侵权或其他问题,请联系举报。








 分享
分享












发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论